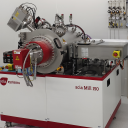
主要规格和技术参数
1,最大样品尺寸直径4英寸晶原;
2,工艺腔本底真空<=5e-7 mbar;
3,预真空室本底真空<=1e-6 mbar;
4, 离子束有效束径 >=218mm
5,离子束最大束压,不低于1000eV,最大束流密度可达1mA/cm2
6,载片工件台,可旋转,转速可调,转速 5-20RPM;
7,载片工件台,角度可倾斜,倾斜角度可调,范围 90~~ -60度,精度+/-0.1度;
8,配HIDEN Analytical Ltd 品牌,SIMS二次离子质谱仪终点监测系统
9,SIMS自动识别终点和设备控制融合
10,刻蚀速率低至15nm/min (4寸晶原,SiO2膜)
11, 刻蚀均匀性 <=2% (4寸晶原,SiO2膜)
主要功能及特色
通过预真空室把样品传入工艺腔,并固定在载片工件台上。工艺气体Ar,利用辉光放电原理将氩气Ar分解为氩离子,氩离子经过阳极电场的加速对样品表面进行物理轰击,以达到刻蚀的作用 。属纯物理刻蚀。
配Hiden Analytical Ltd品牌,SIMS二次离子质谱仪终点检测系统,与设备控制融合,自动识别终点。
属于物理刻蚀,可以刻蚀各种材料。
主要附件及配置
主要配置:
离子束刻蚀主机,真空反应腔室,离子束源,真空系统,控制系统 ,真空进样装置loadlock,SIMS二次离子质谱仪终点监测系统